

No graphs of equivalence are drawn up for supplementary comparisons.
No graphs of equivalence are drawn up for supplementary comparisons.
No degrees of equivalence are computed for supplementary comparisons.
No degrees of equivalence are computed for supplementary comparisons.
| Metrology area, Sub-field | Length, Dimensional Metrology |
| Description | Nanometrology: one-dimensiional gratings |
| Time of measurements | 2022 - 2024 |
| Status | Report in progress, draft A |
| References | |
| Measurand | Pitch 50 nm, 100 nm, 200 nm, 400 nm, 600 nm, 800 nm and1000 nm |
| Parameters | Pitch |
| Transfer device | 1D gratings |
| Comparison type | Supplementary Comparison |
| Consultative Committee | CCL (Consultative Committee for Length ) |
| Conducted by | APMP (Asia Pacific Metrology Programme) |
| Pilot institute |
NIM
National Institute of Metrology China |
| Contact person | Yushu Shi +86 15901234276 |
| Pilot laboratory | |
|---|---|
| NIM |
National Institute of Metrology, China, APMP |
| CMS (became CMS/ITRI) |
ITRI Center for Measurement Standards (became Industrial Technology Research Institute/Center for Measurement Standards), Chinese Taipei, APMP |
| NIMT |
National Institute of Metrology (Thailand), Thailand, APMP |
| NMIA |
National Measurement Institute, Australia, Australia, APMP |
| NMIJ AIST |
National Metrology Institute of Japan, Japan, APMP |
This page proposes print-out on A4 paper (portrait) of the comparison details (best printed out using a black and white printer).
Please, select items to be printed out, then click on "OK" :
Supplementary comparison results are not interpreted in terms of equivalence.
Supplementary comparison results are not interpreted in terms of equivalence.
MEASURAND : Average pitch of grating, measured in central area (1 mm x 1 mm)
NOMINAL PITCH VALUE : P1 = 290 nm
xi1 : result of measurement carried out by laboratory i
ui1 : combined standard uncertainty of xi1 reported by laboratory i
xR1 : reference value for grating of nominal value P1, obtained from the weighted mean of the participant values xi1
uR1 : standard uncertainty of the reference value obtained from the reported standard uncertainties ui1
OD : Optical diffraction
SPM : Scanning probe methods
OM : Optical microscopy

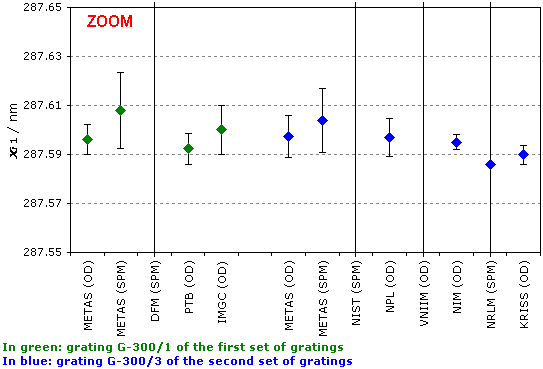
MEASURAND : Average pitch of grating, measured in central area (1 mm x 1 mm)
NOMINAL PITCH VALUE : P2 = 700 nm
xi2 : result of measurement carried out by laboratory i
ui2 : combined standard uncertainty of xi2 reported by laboratory i
xR2 : reference value for grating of nominal value P2, obtained from the weighted mean of the participant values xi2
uR2 : standard uncertainty of the reference value obtained from the reported standard uncertainties ui2

OD : Optical diffraction
SPM : Scanning probe methods
OM : Optical microscopy